河北高精度真空炉
PCoB连接双面散热:虽然双基板封装具备双面散热的能力,但基板与底板连接,引入寄生电感,同时存在基板热阻较大的问题,为提高器件的电气性能和热性能,研究人员提出了一种功率芯片连接在总线上(PowerChiponBus,PCoB)的双面散热封装方法,将芯片连接到2个母线状金属基板上,基板通过预先成型的环氧树脂粘合在一起,金属基板相对于陶瓷基板具有更优异的导热性能。厚翅片铜既作为热沉又作为母线。钼垫片用作芯片和底部基板间的热膨胀缓冲层,以降低因热碰撞系数(CTE)失配引起的热机械应力。动态测试IGBT自动化设备可评估器件在高负载情况下的温度和功耗。河北高精度真空炉
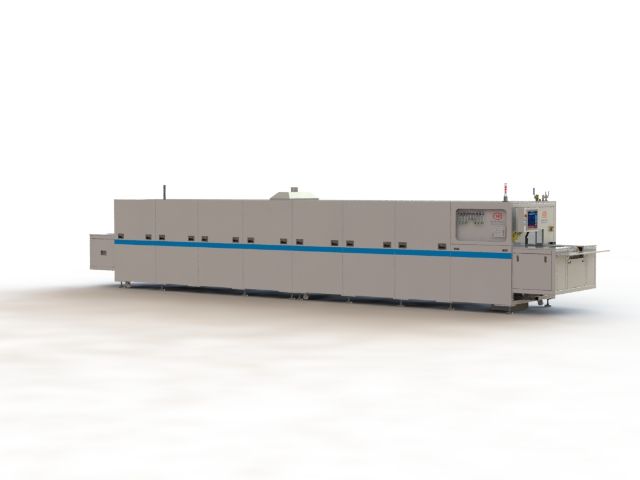
SiC宽禁带半导体功率器件更高的开关频率,可以降低无源器件的重量,占用的封装体积也更小,因此可以提高功率器件的功率密度,同时SiC器件具有更高的热导率,可以更高效的把芯片耗散热排出。然而,SiC器件越来越高的电压等级和开关速度也给器件封装带来巨大的挑战。目前现有封装技术的不适配是摆在高压SiC器件应用面前的一道屏障。SiC芯片尺寸小,厚度更薄,而电压等级提高,需要特别关注封装中涉及芯片、基板以及输出端子等薄弱点的电气绝缘问题,如10kVSiCMOSFET的芯片厚度只有100μm,平均电场强度达到100kV/mm,而对于1.7kV的SiIGBT,芯片厚度为210μm,而平均电场强度只有8.1kV/mm。深圳非标IGBT自动化设备IGBT自动化设备在封装过程中减少了人工操作的错误风险。

采用烧结银工艺将芯片倒装烧结到DBC基板上,芯片背面采用铜夹连接,铜夹上连接散热器,形成芯片上表面的热通路。采用聚合物热界面材料在模块的上下表面连接两个陶瓷散热器,进行双面散热。由于芯片倒装键合面积只占芯片面积的很小一部分,接触面积较小成为限制该封装散热性能的关键。该封装中倒装芯片键合层和铜夹连接层对模块热性能的影响比连接散热器的热界面材料的影响更加明显。增大倒装芯片的键合面积有助于降低倒装芯片键合层的热阻,有利于降低芯片结温。研究表明,通过增大芯片电极金属化面积,如将芯片电极面积占比从22%提高到88%,采用倒装键合,芯片结温可降低20-30℃。建议可以通过采用扩大芯片电极金属化面积,增大键合面积的方式来降低热阻。
4种AlN基板可靠性测试(冷热冲击):对4种AlN覆铜基板循环进行冷热冲击热循环实验,条件为在-55℃~150℃,每个温度保温30min,5s内完成到155℃温度转换,循环次数为100cycles、500cycles、1000cycles、1500cycles。可得AMB法制备的AlN覆铜板耐热冲击次数明显高于其他制备工艺。AlN覆铜板耐热冲击主要的失效模式为金属层剥离和AlN陶瓷基板开裂。对于DPC基板,在200次冷热循环后,金属层与AlN完全剥离,剥离强度为0。AlN厚膜覆铜板,在500次冷热循环后,金属层有局部剥离,剥离强度降为百分之二十。DBC基板在1000次冷热循环后,剥离强度降低了20%,但去除金属层,通过超声波扫描显微镜探测,与铜结合边缘处AlN基板有微裂纹,这是由于金属Cu和AlN的热膨胀系数差别大,两者在高温急速降温过程中,材料内部存在大量的热应力,而导致开裂。AMB基板在1500次冷热循环后,金属层剥离力无下降现象,陶瓷表面无微裂纹。由于金属层与AlN陶瓷之间有刚度较低的活性钎料过渡层,可以避免大量的热应力形成而造成的AlN陶瓷基板微裂纹产生。动态测试IGBT自动化设备可用于验证器件的可控性和稳定性。

IGBT作为重要的电力电子的中心器件,其可靠性是决定整个装置安全运行的重要因素。由于IGBT采取了叠层封装技术,该技术不但提高了封装密度,同时也缩短了芯片之间导线的互连长度,从而提高了器件的运行速率。传统Si基功率模块封装存在寄生参数过高,散热效率差的问题,这主要是由于传统封装采用了引线键合和单边散热技术,针对这两大问题,SiC功率模块封装在结构上采用了无引线互连(wireless interconnection)和双面散热(double-side cooling)技术,同时选用了导热系数更好的衬底材料,并尝试在模块结构中集成去耦电容、温度/电流传感器以及驱动电路等,研发出了多种不同的模块封装技术。IGBT自动化设备确保封装过程中IGBT模块的稳定性和可靠性。高精度无功老化测试设备制造商
IGBT自动化设备通过真空回流焊接确保了贴片的可靠连接和高质量的焊接效果。河北高精度真空炉
TFC金属化是一种在AlN陶瓷基板上制作铜膜的过程,它通过使用铜浆料和丝网印刷技术,将铜浆料均匀地涂布在基板上。在涂布完成后,通过850℃真空烧结处理,使铜膜与基板牢固结合,并形成TFC覆铜AlN基板。DBC金属化则是一种将AlN基板与铜箔进行冶金结合的制作方法。首先将AlN基板与铜箔精确对齐,然后将它们装配在一起,施加一定的压力。随后,在控制炉内氧分压的情况下,将温度加热至1065℃,使得铜箔表面的氧化物薄层与AlN基板表面氧化产生的三氧化二铝(Al2O3)发生化学反应,生成一种称为CuAlO2的化合物。这种化合物将铜箔和AlN基板紧密地结合在一起,形成冶金结合。而AMB金属化是一种在AlN表面制作铜膜的另一种方法。首先,在AlN表面涂布一层含有银(Ag)、铜(Cu)和钛(Ti)的焊膏,然后覆盖一层铜箔。接下来,将样件置于真空环境中,加热至890℃并保持一段时间,这样就可以使AlN表面上的焊膏与铜箔发生反应,形成一层坚固的铜膜。这样制作的覆铜AlN基板具有良好的导热性能,可用于高功率电子器件的封装。河北高精度真空炉
上一篇: 在线式CCS点胶机厂家
下一篇: 河北大型CCS点胶机生产厂家