非标真空炉规格
采用银烧结将芯片和柔性PCB板分别连接到两个DBC上,将CMC金属块烧结到每个芯片的表面,随后将两个DBC板焊接在一起并进行真空灌封硅凝胶密封。两侧DBC外表面为器件散热提供了双散热通路。高温环境下SiCMOSFET电流容量降低,并联芯片通常由于并联分支间的寄生不匹配导致电流不平衡,进而导致芯片温度分布不均,且并联芯片间热耦合严重,影响器件散热。研究者提出一种交错平面封装的新型半桥封装结构,该结构基于平面封装原理,具备双面散热能力。交错平面封装使任意两个相邻的并联芯片在空间上交错排列,可以避免芯片间的热耦合,实现更好的热性能。上下基板分别起到导电、导热、绝缘和机械支撑的作用。IGBT自动化设备的动态测试具备实时监测和报警功能。非标真空炉规格

IGBT模块封装的流程大致如下:X-ray空洞检测,需要检测在敢接过程中出现的气泡情况,即空洞,空洞的存在将会严重影响器件的热阻和散热效率,以致出现过温、烧坏等问题。一般汽车IGBT模块要求空洞率低于1%;接下来是wire bonding工艺,用金属线将die和DBC键合,使用较多的是铝线,其他常用的包括铜线、铜带、铝带;中间会有一系列的外观检测、静态测试,过程中有问题的模块直接报废;重复以上工序将DBC焊接和键合到铜底板上,然后是灌胶、封壳、激光打码等工序;出厂前会做功能测试,包括电气性能的动态测试、绝缘测试、反偏测试等等。无功老化测试设备尺寸IGBT自动化设备推动了IGBT模块技术的发展,使其具备通态压降低、开关速度快等优点。

通过改变导通路径上的几何形状,增大接触面积,有效降低了高压下导电路径的寄生电感和电阻。该薄板可采用具有良好导电和导热性能的金属铜等制成,大的接触面积也有利于芯片热量的传导,提高散热能力。考虑到接触界面热膨胀系数的匹配性,可采用CuMo或CuW合金代替铜。金属板连接比相同电流下的键合线连接具有更低的焦耳热。采用6根300μm铝线键合封装和采用PowerStep封装的模块热性能对比,同样100W的芯片耗散热,PowerStep封装模块结壳热阻降低10%。采用铝键合线封装,通入25A电流产生的焦耳热使铝线产生了6℃的温升;而采用PowerStep封装,通入电流是铝线键合的4倍,而产生的焦耳热温升只是前者的三分之一,充分表明PowerStep封装在降低热耗散方面更具优势。
对于AMB基板,由于中间有1层活性钎料,其中的Ti元素对附着力起到关键因素,Ti元素与AlN基板反应生成TiN,可以提升金属层的附着力。对于DBC基板,在覆铜过程中Cu箔与微量氧气生成Cu2O,而Cu2O可以与金属Cu形成共晶组织。AlN基板在覆Cu箔之前通常需要对其进行预氧化处理,形成几个μm厚度的Al2O3层,Cu2O与Al2O3可以在高温下生成CuAlO2化合物,因此AlN基板与覆Cu层具有很好的界面结合。TFC基板的附着力主要由浆料内部的玻璃成分决定,高温烧结过程中玻璃软化并与陶瓷基板润湿产生结合,此外软化的玻璃还可以锚接铜粉烧结形成的金属化层,从而使金属化层与陶瓷基板牢固结合。对于DPC陶瓷基板,电镀Cu层与AlN基板之间只有一层Ti薄膜层,该薄膜与陶瓷基板只有物理结合,因此金属层结合力较低。自动化设备实现了IGBT模块的快速生产和高质量标准。
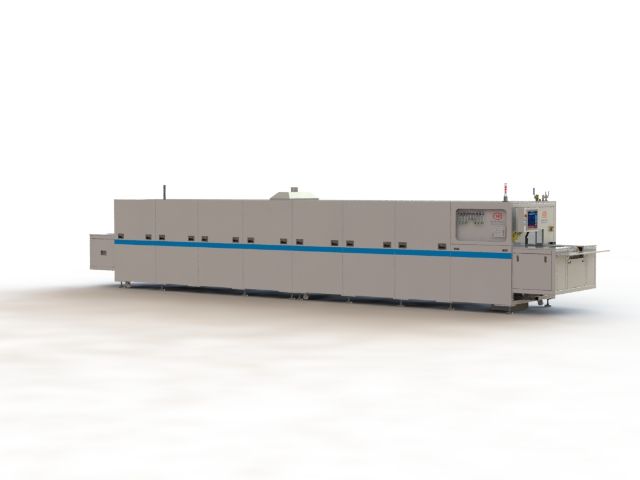
常见的汽车IGBT模块封装类型有哪些?Econodual 系列半桥封装,应用在商用车上为主,主要规格为1200V/450A,1200V/600A等;HP1全桥封装,主要用在中小功率车型上,包括部分A级车、绝大部分的A0、A00车,峰值功率一般在70kW以内,型号以650V400A为主,其他规格如750V300A、750V400A、750V550A等;HPD全桥封装,中大功率型车上使用,大部分A级车及以上,以750V820A的规格占据市场主流,其他规格如750V550A等;DC6全桥封装,基于UVW三相全桥的整体式封装方案,具备封装紧凑,功率密度高,散热性能好等特点。IGBT自动化设备的动态测试可验证器件在高频环境下的稳定性和响应。一体化无功老化测试设备厂商
IGBT自动化设备为动态测试提供了可靠的电源和载荷控制。非标真空炉规格
4种AlN基板功率循环耐测试:为了更好地评估AlN覆铜板耐久性和寿命,将4种AlN覆铜板以常规工艺封装成IGBT模块,用硅胶进行密封保护,恒定功率为1200A/3.3kV、0~85000次循环测试,验证4种AlN覆铜板IGBT模块的功率循环可靠性。器件的起始温度T0设置为45℃,Tc为循环后的温度,相对热阻Rr下式计算,可得AMB陶瓷基板IGBT模块在7万次功率循环后,模块温度为50℃,相对热阻<15%,满足电力电子器件特别是高压、大电流IGBT模块可靠性要求(相对热阻<15%)。DBC陶瓷基板IGBT模块在4万次循环前,相对热阻保持在15%以内,超过4万次,模块温度逐渐增高,相对热阻(>15%)超出了可靠性要求。DPC陶瓷基板在1万次相对热阻为22%,器件受到破坏,在3万次循环后器件完全失效。TFC陶瓷基板在2万次循环后相对热阻为33%,器件受到破坏,4.5万次循环后器件完全失效。非标真空炉规格
上一篇: 山西网带式气氛烤炉厂家供应
下一篇: 一体化共晶真空炉定制价格