湖南一体化真空封盖自动线
功率器件封装结构散热设计原则:从器件散热的角度,封装结构设计应当遵循散热路径低热阻、尽可能多散热路径和传热路径上的接触面积尽可能大的原则。这就要求在设计之初,就应考虑到封装材料的选择、散热路径的设计、散热路径上各部件接触界面的面积等。但这些不可避免的增加了封装设计和工艺实现的难度,一种功率器件的封装实践往往是考虑多种因素的折中。从目前国内外对于功率器件的研究和开发现状来看,具备耐高温、多散热路径和大面积连接的封装特征是未来功率器件封装的发展趋势,也是满足未来高压、大功率器件工作性能要求的必然选择。IGBT自动化设备推动了IGBT模块技术的发展,使其具备通态压降低、开关速度快等优点。湖南一体化真空封盖自动线

对于AMB基板,由于中间有1层活性钎料,其中的Ti元素对附着力起到关键因素,Ti元素与AlN基板反应生成TiN,可以提升金属层的附着力。对于DBC基板,在覆铜过程中Cu箔与微量氧气生成Cu2O,而Cu2O可以与金属Cu形成共晶组织。AlN基板在覆Cu箔之前通常需要对其进行预氧化处理,形成几个μm厚度的Al2O3层,Cu2O与Al2O3可以在高温下生成CuAlO2化合物,因此AlN基板与覆Cu层具有很好的界面结合。TFC基板的附着力主要由浆料内部的玻璃成分决定,高温烧结过程中玻璃软化并与陶瓷基板润湿产生结合,此外软化的玻璃还可以锚接铜粉烧结形成的金属化层,从而使金属化层与陶瓷基板牢固结合。对于DPC陶瓷基板,电镀Cu层与AlN基板之间只有一层Ti薄膜层,该薄膜与陶瓷基板只有物理结合,因此金属层结合力较低。江西高精度共晶真空炉动态测试IGBT自动化设备可精确测量器件的开关速度和损耗。

通过改变导通路径上的几何形状,增大接触面积,有效降低了高压下导电路径的寄生电感和电阻。该薄板可采用具有良好导电和导热性能的金属铜等制成,大的接触面积也有利于芯片热量的传导,提高散热能力。考虑到接触界面热膨胀系数的匹配性,可采用CuMo或CuW合金代替铜。金属板连接比相同电流下的键合线连接具有更低的焦耳热。采用6根300μm铝线键合封装和采用PowerStep封装的模块热性能对比,同样100W的芯片耗散热,PowerStep封装模块结壳热阻降低10%。采用铝键合线封装,通入25A电流产生的焦耳热使铝线产生了6℃的温升;而采用PowerStep封装,通入电流是铝线键合的4倍,而产生的焦耳热温升只是前者的三分之一,充分表明PowerStep封装在降低热耗散方面更具优势。
汽车IGBT模块要做哪些测试验证?汽车IGBT模块对产品性能和质量的要求要明显高于消费和工控领域,因此车规认证成为了汽车IGBT模块市场的重要壁垒,一般来说,车规级IGBT需要2年左右的车型导入周期。汽车IGBT模块测试标准主要参照AEC-Q101和AQG-324,同时车企会根据自己的车型特点提出相应的要求,主要测试方法包括:参数测试、ESD测试、绝缘耐压、机械振动、机械冲击、高温老化、低温老化、温度循环、温度冲击、UHAST(高温高湿无偏压)、HTRB(高温反偏)、HTGB(高温删偏)、H3TRB/HAST(高温高湿反偏)、功率循环、可焊性。IGBT自动化设备的应用提升了功率半导体模块封装的工艺技术水平,使其适应更高的功率密度和恶劣环境。
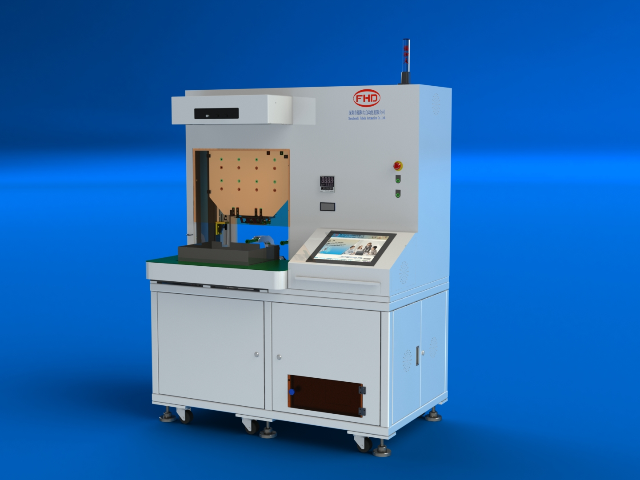
功率器件封装结构散热设计原则:针对功率器件的封装结构,国内外研究机构和企业在结构设计方面进行了大量的理论研究和开发实践,多种结构封装设计理念被国内外研究机构提出并研究,一些结构设计方案已成功应用在商用功率器件上。功率器件自身的属性及其特殊的服役环境决定了封装器件内部总是受到电场、热以及应力等多种场效应相互耦合的综合作用。功率器件的结构设计,应首先要满足电气绝缘要求,在此基础上兼顾结构设计对封装散热、芯片及封装各部件间受力等其他方面的影响。在自动键合阶段,IGBT自动化设备能够精确地进行键合打线,实现电路的完整连接。真空炉厂商
自动化设备保证了IGBT模块的高可靠性和高功率密度要求。湖南一体化真空封盖自动线
键合线与半导体器件间存在材料热膨胀系数的不匹配,使得线键合处往往成为易失效位点,甚至出现裂纹或者松动,导致接触不良,使键合点处的接触热阻增大,温度升高,加速该点的失效。无键合线单面散热器件芯片与基板的连接与键合线连接器件相同。无键合线面互连封装降低了封装寄生电感和电阻,大的接触面积增强了传热。上述封装结构只能通过由芯片底部的陶瓷基板和底板构成的路径进行散热。目前键合线连接的硅基器件单面散热封装结构已接近其散热极限,硅芯片的工作结温也接近其承受上限,严重影响了器件的性能,更限制了具有更高温度运行能力的SiC器件的性能。从散热的角度看,功率器件产生的热量只能通过底面传递,限制了其散热性能。在目前封装材料性能和封装工艺暂时无法取得较大改善的情况下,通过创新结构布局和设计,优化散热路径,是解决功率器件封装散热的有效方案。湖南一体化真空封盖自动线
上一篇: 北京连续式网带式气氛烤炉规格
下一篇: 河南屏蔽膜FPC热压自动置料机价位