天津一体化真空炉
功率模块是实现绿色能源转换的重要部件,绝缘栅门极晶体管( Insulated Gate Bipolar Translator,IGBT) 作为使用频率[敏感词]的电源转换芯片,是出现故障频率[敏感词]的器件,其失效机理及检测方式被大量研究。可靠的封装为芯片工作提供稳定的电气连接、良好的绝缘性能和充分的抗干扰能力,是IGBT功率模块可靠性的重要组成部分。现在被主流使用的封装形式有焊接型和压接型封装。两种封装结构在功率密度、串并联能力、制造费用、封装可靠性和散热能力等方面有所不同。由于压接型封装具有双面冷却和失效自短路效应,其在散热、可靠性及串联能力上优于焊接型封装,因此被普遍用于高功率密度场合,如高压电网和高功率机械设备,但封装复杂笨重。焊接型封装结构因其制造工艺简单、成本低和并联能力强被普遍使用在中低功率密度场合,如消费电子、汽车电子。两种封装结构导致了不同的失效机理,但其本质多是IGBT 芯片工作产生的热量未即时耗散,引起温度梯度,较终导致的封装材料疲劳致使失效。IGBT模块动态、静态测试系统是IGBT模块研发和制造过程中重要的测试系统。天津一体化真空炉

IGBT模块的生产过程涉及多个阶段。在真空回流焊接过程中,芯片与铜直接键合(DBC)由于工艺限制,基板上铜层之间的焊料层和DBC下铜层与模块底板之间的焊料层会出现空洞。焊接层的空洞缺陷也会出现在贴片工艺步骤中。由于材料的热膨胀系数,IGBT模块在使用过程中空洞不稳定(CTE,热膨胀系数)的不匹配会产生热应力,从而进一步扩大工作过程中模块温度的变化。甚至导致相邻的空洞连接成一块,促进焊接层分层,导致模块功能故障。空洞的原因有很多,极大地影响了模块的热性能,增加了模块的热阻,降低了散热性能,增加了设备的局部温度,甚至进一步降低了模块的可靠性和使用寿命。工业模块自动组装线尺寸IGBT的热效应比MOSFET要小,可以达到20°C-150°C之间。

电迁移、电化学腐蚀和金属化重构,IGBT 功率模块芯片顶部存在一层 Al 金属薄膜用以与外部进行连接。在电流和温度梯度的作用下,Al 金属离子会沿着导体运动,如沿着键合线运动,产生净质量输运,导致薄膜上出现空洞、小丘或晶须。随着器件的老化,有机硅凝胶的气密性下降,外部的物质会与 Al 金属薄膜接触,使其发生电化学腐蚀。常见的有 Al 的自钝化反应、单一阳极腐蚀电池反应以及与沾污的离子发生反应。金属化重构是由于 Al 与芯片上 SiO2 的 CTE 值相差两个数量级,导致界面处产生循环应力,使得Al 原子发生扩散,造成小丘、晶须和空洞,然后产生塑性形变,引发裂纹。以上所述三种因素导致的 Al 薄膜失效方式会加剧键合点处的疲劳情况,较终导致键合线脱落或电场击穿失效。
IGBT的作用:1. IGBT可以用作开关元件来控制电力,如电源的输入和输出;2. IGBT可以作为放大器,用来放大高频信号;3. IGBT可以用于恒定电压输出,可以保持电源的稳定性;4. IGBT可以用于现场可控硅(FACTS),用于调整电力系统的频率、电压和功率;5. IGBT可以用于逆变电路,提供可靠的正弦电压和频率;6. IGBT可以用于电力调节,提供电力调节和监控系统;7. IGBT可以用于电机控制,如三相伺服电机控制系统;8. IGBT可以用于高压电磁转换器,用于电力转换和调节;9. IGBT可以用于电力变换器,用于电力转换和调节;10. IGBT可以用于发电机控制,用于发电机自动控制系统。IGBT可以用于电机控制,如三相伺服电机控制系统。
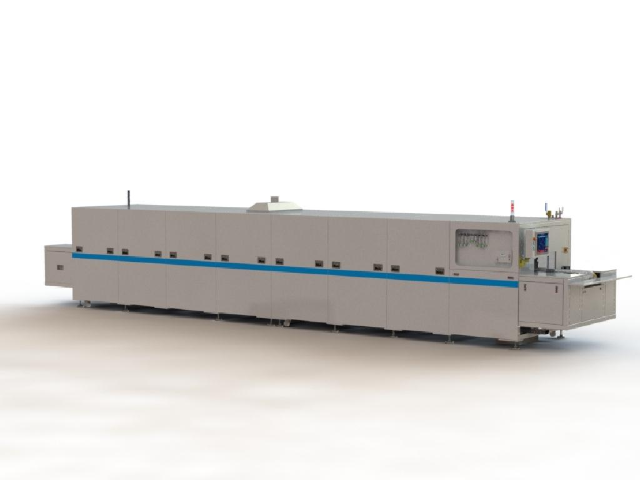
如今,对于电子产品市场来说,越来越多的技术创新需要相应的技术支持。比如电脑中的板卡虽然经历了技术创新,但如果焊接技术不稳定,对于电脑整体来说是不可估量的损失。真空回流焊接技术应运而生,焊接效果好,非常稳定。我给大家简单说一下真空焊接技术。共晶焊接具有导热率高、电阻小、传热快、可靠性强、粘接后剪切力大的优点,适用于芯片与基板、基板与管壳在高频大功率设备中的互联。对于散热要求较高的功率设备,必须采用共晶焊接。共晶焊接利用共晶合金的特性来完成焊接过程。绝缘层:它是IGBT的基础,它由一层绝缘层构成,它可以保护IGBT元件免受外界环境的侵蚀和损坏。甘肃非标DBC底板贴装机
IGBT主要的物料有IGBT芯片,二极管,五金件,键合丝,陶瓷基板,外壳等。天津一体化真空炉
陶瓷封装,在实际应用中,它已经成为[敏感词]的封装介质,因为它易于组装,易于实现内部连接和低成本。陶瓷可以承受苛刻的外部环境、高温、机械冲击和振动。它是一种坚硬的材料,具有接近硅材料的热膨胀系数值。这类设备的封装可以使用共晶焊接的陶瓷腔体上部有一个密封环,用于与盖板共晶焊接,以获得气密和真空焊接。金层通常需要1.5。μm,但由于工艺处理和高温烘烤,腔体和密封环都需要电镀2.5μ大量的黄金用于保护镍的迁移。镀金可伐盖板可用作气密封焊陶瓷管壳的材料,一般在共晶前进行真空烘烤。天津一体化真空炉
上一篇: 一体化网带式气氛烤炉定制价格
下一篇: 一体化超声波键合机供应商