专业工业模块自动组装线厂家直销
目前商用的SiC肖特基二极管受限于传统塑料封装形式,其额定工作结温上限只能达到175℃。现有SiC器件的封装仍主要采用焊接封装,考虑到芯片绝缘和隔离外界环境的目的,封装模块内部灌封有完全覆盖芯片表面的热导率较低的硅凝胶,硅凝胶上层为空气,该封装形式也使得这种从上向下的热传导成为芯片产生热量的散热通道。为了充分利用SiC器件高结温的优势,发挥SiC器件的潜力,开发新的便于芯片散热的封装结构,为芯片封装提供高效的散热路径,达到降低芯片结温,提升器件整体性能的目的,非常有必要改进现有的传统功率器件封装技术,开发新型功率器件封装结构。由此,通过增加封装器件的散热路径来提高器件散热能力的方法也就很自然的被提出。在壳体灌胶与固化过程中,IGBT自动化设备能够确保完整的绝缘保护和固化效果。专业工业模块自动组装线厂家直销
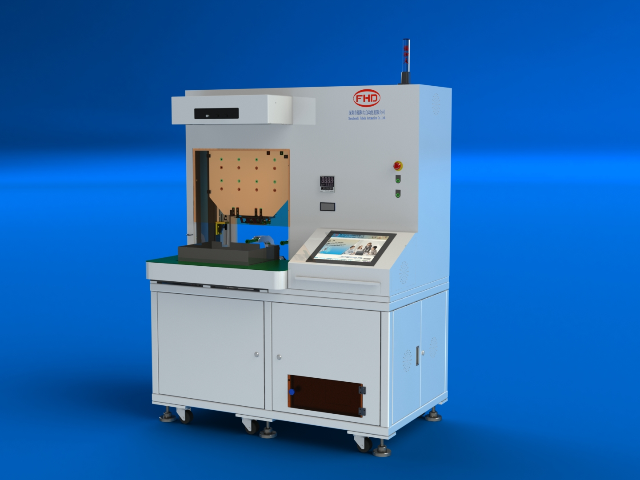
封装结构散热类型:以传统半导体Si芯片和单面散热封装为表示的常规封装器件获得了良好的发展和应用,技术上发展相对比较成熟。但随着对更高电压等级更高功率密度需求的不断增长,传统应用于Si器件的封装技术已不能够满足现有发展和应用的要,目前传统Si基芯片的至高结温不超过175℃,温度循环的范围至大不超过200℃。相比Si器件,SiC器件在导通损耗、开关频率和具有高温运行能力方面具有明显的优势,至高理论工作结温更是高达600℃。若采用现有Si基封装技术,那么以SiC为表示的宽禁带半导体将无法充分发挥其高温运行的能力。山西高精度DBC底板贴装机IGBT自动化设备负责封装和端子成形,保证产品的完整性和可靠性。

在activemetalbrazing(AMB)基板中有特殊设计的空腔,将芯片嵌入到AMB空腔里,采用定制的铜夹连接芯片和AMB基板,使其与基板上金属层在同一水平面,即在封装上侧形成平面,可以在该表面和AMB基板的下表面分别连接散热器,实现双面散热。嵌入到AMB基板封装的单面散热、双面散热与传统键合线连接封装单面散热的热性能对比。结果显示,芯片嵌入AMB基板单面散热封装模块相比传统键合线连接单面散热模块,结壳热阻降幅可达40%。若在芯片嵌入AMB基板采用双面散热封装,模块的结壳热阻可进一步降低20%。
功率器件正呈现出高频、高压、高功率以及高温的发展特点。同时这些特征也对功率器件封装提出了巨大挑战,需要考虑到封装结构、封装材料和封装工艺的可行性和适配性,这些涉及到器件的封装电感、芯片散热和电气绝缘等问题,倘若这些不能够很好的得到解决,就会对器件的热学、电学、机械性能和可靠性产生极大的影响,甚至导致器件的失效。尤其是在目前功率器件高电压、大电流和封装体积紧凑化的发展背景下,封装器件的散热问题已变得尤为突出且更具挑战性。在IGBT模块的标准封装中,自动化设备确保塑料外壳和金属底板的准确组装。
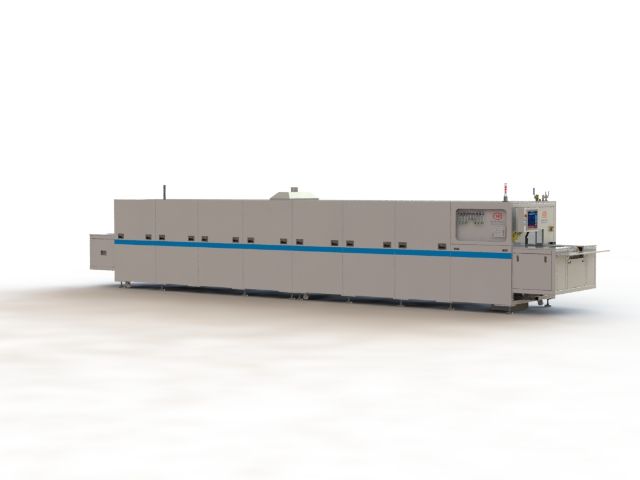
无键合线单面散热:取消键合线有助于改善器件封装寄生电感和封装可靠性。超紧凑高可靠性SiCMOSFET模块,取消键合线和底板,将芯片直接焊接到基板上,采用铜针取代铝键合线,同时在高导热SiN陶瓷上设计了类似于热扩散器的更厚铜块,具有更好的传热效果。相比Al2O3陶瓷基板的键合线结构,采用Al2O3陶瓷的厚铜块封装模块结壳热阻降低37%,采用SiN陶瓷的厚铜块封装模块结壳热阻降低55%。同时该封装采用新型环氧树脂和银烧结技术,具有高达200℃的高温运行能力。动态测试IGBT自动化设备可提供高效的数据采集和分析功能。北京非标真空炉
IGBT自动化设备可实现对动态特性的实时测试和监测。专业工业模块自动组装线厂家直销
键合线与半导体器件间存在材料热膨胀系数的不匹配,使得线键合处往往成为易失效位点,甚至出现裂纹或者松动,导致接触不良,使键合点处的接触热阻增大,温度升高,加速该点的失效。无键合线单面散热器件芯片与基板的连接与键合线连接器件相同。无键合线面互连封装降低了封装寄生电感和电阻,大的接触面积增强了传热。上述封装结构只能通过由芯片底部的陶瓷基板和底板构成的路径进行散热。目前键合线连接的硅基器件单面散热封装结构已接近其散热极限,硅芯片的工作结温也接近其承受上限,严重影响了器件的性能,更限制了具有更高温度运行能力的SiC器件的性能。从散热的角度看,功率器件产生的热量只能通过底面传递,限制了其散热性能。在目前封装材料性能和封装工艺暂时无法取得较大改善的情况下,通过创新结构布局和设计,优化散热路径,是解决功率器件封装散热的有效方案。专业工业模块自动组装线厂家直销
上一篇: 高精度工业模块自动组装线价位
下一篇: 静态测试真空炉厂家供应