静态测试真空灌胶自动线参考价
汽车IGBT模块要做哪些测试验证?汽车IGBT模块对产品性能和质量的要求要明显高于消费和工控领域,因此车规认证成为了汽车IGBT模块市场的重要壁垒,一般来说,车规级IGBT需要2年左右的车型导入周期。汽车IGBT模块测试标准主要参照AEC-Q101和AQG-324,同时车企会根据自己的车型特点提出相应的要求,主要测试方法包括:参数测试、ESD测试、绝缘耐压、机械振动、机械冲击、高温老化、低温老化、温度循环、温度冲击、UHAST(高温高湿无偏压)、HTRB(高温反偏)、HTGB(高温删偏)、H3TRB/HAST(高温高湿反偏)、功率循环、可焊性。在自动键合阶段,IGBT自动化设备能够精确地进行键合打线,实现电路的完整连接。静态测试真空灌胶自动线参考价

IGBT模块封装的流程大致如下:X-ray空洞检测,需要检测在敢接过程中出现的气泡情况,即空洞,空洞的存在将会严重影响器件的热阻和散热效率,以致出现过温、烧坏等问题。一般汽车IGBT模块要求空洞率低于1%;接下来是wire bonding工艺,用金属线将die和DBC键合,使用较多的是铝线,其他常用的包括铜线、铜带、铝带;中间会有一系列的外观检测、静态测试,过程中有问题的模块直接报废;重复以上工序将DBC焊接和键合到铜底板上,然后是灌胶、封壳、激光打码等工序;出厂前会做功能测试,包括电气性能的动态测试、绝缘测试、反偏测试等等。无功老化测试设备厂商自动化设备的应用使IGBT模块的封装工艺更加智能化和高效化。
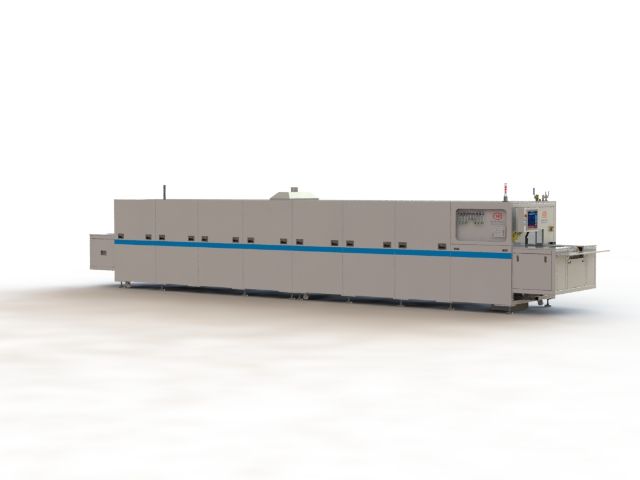
要实现双面散热,需要对芯片的两个表面实现面连接,这样才能在芯片两侧形成两个平面,实现两个热通路。另一种实现面连接的方式是在芯片的两侧均采用DBC基板连接。通过采用“Planar-bond-all,(PBA)”的功率模块封装方法可以在芯片的上表面实现大面积键合平面互连。芯片正面朝上/朝下键合在两个DBC之间,两个铜制热沉直接连接在两侧DBC的外表面上。封装时将DBC基板、芯片、垫片、键合材料、功率端子等组装在夹具中,然后同时加热形成键合。双侧平面键合可以使封装的上下两个表面都成为散热通路。此外,热沉与DBC基板直接连接进一步降低了封装热阻。
现有press-pack封装包括直接压力接触和弹性接触两种方式,但都需要大的芯片面积且需要对芯片上层金属化进行特殊设计。SiC芯片面积比硅芯片小,芯片表面常采用铝进行金属化。为实现压力接触,采用被称作“Fuzzbuttons”的柔性微型压针插入到薄的插接体中,以产生均匀的压力分布,并使引入的寄生电感更小。该press-pack夹在两个液冷微通道散热器之间,SiC芯片连接在金属钼底板上。带有“Fuzzbuttons”微型柔性压针的压力接触插接体将SiC芯片的源极和栅极连接到上部基板。该多层结构的上基板将芯片的源极和上部铜板连接,并为栅极驱动器提供栅极和开尔文源极端子。IGBT自动化设备提高了功率半导体器件封装的一致性和可靠性。

汽车IGBT模块测试标准下功率循环和温度循环作为表示的耐久测试,要求极为严格,例如功率循环次数可能从几万次到十万次不等。主要目的是测试键合线、焊接层等机械连接层的耐久情况。测试时的失效机理主要是,芯片、键合线、DBC、焊料等的热膨胀系数不一致,导致键合线脱落、断裂,芯片焊层分离,以及焊料老化等。随着国内新能源汽车产业的快速发展,产业链上游大有逐步完成国产替代,甚至带领世界的趋势,诸如整车品牌、动力电池、电池材料等等已经走得比较靠前,而汽车电控IGBT模块是新能源汽车主要的功率器件。IGBT自动化设备实现了功率半导体器件封装过程中的自动化操作和控制。静态测试真空灌胶自动线参考价
动态测试IGBT自动化设备能够验证器件在不同工况下的性能表现。静态测试真空灌胶自动线参考价
芯片背面可通过焊层与DBC基板连接。芯片封装上下两个外表面均为平面,可在两侧分别连接热沉进行冷却。研究表明,器件功率损失在5~300W范围内时,与键合线连接的单面液冷相比,嵌入式封装双面液冷热阻可降低45%~60%。且随着冷却流体流速的增加,散热效果更加明显。因此,使用嵌入式功率芯片封装的双面液体对流散热是改善功率半导体器件散热的可行且有效方案。与常规芯片封装相反,将芯片正面连接在DBC上,芯片背面通过铜夹引出,即可实现芯片的倒装封装,实现芯片两个表面散热。静态测试真空灌胶自动线参考价
上一篇: 山东CCS点胶机厂家
下一篇: 深圳高速CCS点胶机制造商