安徽动态测试真空灌胶自动线
半导体技术的进步使得芯片的尺寸得以不断缩小,倒逼着封装技术的发展和进步,也由此产生了各种各样的封装形式。当前功率器件的设计和发展具有低电感、高散热和高绝缘能力的属性特征,器件封装上呈现出模块化、多功能化和体积紧凑化的发展趋势。为实现封装器件低电感设计,器件封装结构更加紧凑,而芯片电压等级和封装模块的功率密度持续提高,给封装绝缘和器件散热带来挑战。在有限的封装空间内,如何把芯片的耗散热及时高效的释放到外界环境中以降低芯片结温及器件内部各封装材料的工作温度,已成为当前功率器件封装设计阶段需要考虑的重要问题之一。在IGBT模块的标准封装中,自动化设备确保塑料外壳和金属底板的准确组装。安徽动态测试真空灌胶自动线
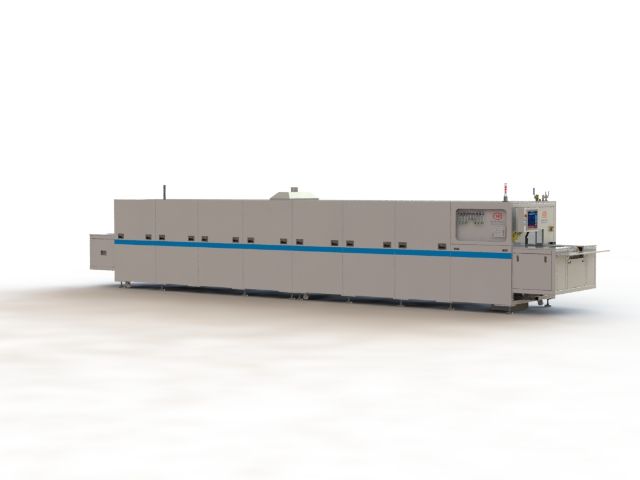
BeO的热导率虽与AlN相当,但热膨胀系数过高,且BeO粉体有毒性,吸入人体后会导致慢性铍肺病,世界上大多数国家早已停止使用BeO。相比而言,AlN陶瓷基板具有高的导热性(理论值319W/(m·K))与Si等半导体材料较匹配的热导率、宽的操作温度(工作温度范围和耐高温方面)和优良的绝缘性能,在大功率电力半导体模块、智能功率组件、汽车电子、高密度封装载板和发光二极管(LED)等方面有很好的发展前景,是先进集成电路陶瓷基板重要的材料之一。AlN基板金属化技术主要有厚膜法(TFC)、薄膜法(DPC)、直接覆铜法(DBC)及活性金属钎焊法(AMB)等方法。动态测试外壳组装兼容设备参考价动态测试IGBT自动化设备可分析和优化器件在过温和过压情况下的性能。

采用纳米银烧结将Mo柱、SiC芯片和Cu柱连接到基板上。相比合金焊料,烧结银导热性能优异,有助于降低芯片连接层的热阻。可在两侧基板表面分别连接热沉进行双面散热。该双面散热封装模块的结壳热阻只有0.17℃/W,封装耗散功率密度超过200W/cm2,而同电压等级的CreeXHV-9模块的结壳热阻为0.468℃/W,表明该双面散热封装具有明显的热性能优势。为进一步优化双面散热封装器件的热性能,提出了柔性印刷电路板互连的平面封装结构,采用Cu-Mo-Cu(CMC)复合金属块满足绝缘要求。柔性PCB板既可以作为芯片上较小特征的互连,还可以代替传统的母线,缩短功率模块的电气回路长度减小寄生电感。
TFC金属化是一种在AlN陶瓷基板上制作铜膜的过程,它通过使用铜浆料和丝网印刷技术,将铜浆料均匀地涂布在基板上。在涂布完成后,通过850℃真空烧结处理,使铜膜与基板牢固结合,并形成TFC覆铜AlN基板。DBC金属化则是一种将AlN基板与铜箔进行冶金结合的制作方法。首先将AlN基板与铜箔精确对齐,然后将它们装配在一起,施加一定的压力。随后,在控制炉内氧分压的情况下,将温度加热至1065℃,使得铜箔表面的氧化物薄层与AlN基板表面氧化产生的三氧化二铝(Al2O3)发生化学反应,生成一种称为CuAlO2的化合物。这种化合物将铜箔和AlN基板紧密地结合在一起,形成冶金结合。而AMB金属化是一种在AlN表面制作铜膜的另一种方法。首先,在AlN表面涂布一层含有银(Ag)、铜(Cu)和钛(Ti)的焊膏,然后覆盖一层铜箔。接下来,将样件置于真空环境中,加热至890℃并保持一段时间,这样就可以使AlN表面上的焊膏与铜箔发生反应,形成一层坚固的铜膜。这样制作的覆铜AlN基板具有良好的导热性能,可用于高功率电子器件的封装。超声波清洗步骤中,IGBT自动化设备能够有效去除焊接后的污染物,保证封装质量。

使用岛津拉力机分别测试四种金属化方法制备的覆铜AlN陶瓷基板的剥离强度,使用冷热冲击试验箱测试覆铜基板可靠性,对基板进行功率循环测试和热阻测试。AlN陶瓷金属化铜层与基板的结合力大小决定了其在实际应用过程中的可靠与否,是陶瓷金属化基板的中心性能指标。本文借鉴《微电子技术用贵金属浆料测试方法附着力测定》中的方法,通过剥离强度测试金属化层的附着力。可得AMB金属化陶瓷基板陶瓷与金属化层结合力较好,剥离强度为25Mpa,接下来是DBC和TFC金属化陶瓷基板,剥离强度分别为21Mpa和15Mpa,更差的是DPC金属化基板,剥离强度只为13Mpa。IGBT自动化设备负责封装和端子成形,保证产品的完整性和可靠性。安徽动态测试真空灌胶自动线
动态测试IGBT自动化设备对产品出厂前的检验提供了支持。安徽动态测试真空灌胶自动线
采用烧结银工艺将芯片倒装烧结到DBC基板上,芯片背面采用铜夹连接,铜夹上连接散热器,形成芯片上表面的热通路。采用聚合物热界面材料在模块的上下表面连接两个陶瓷散热器,进行双面散热。由于芯片倒装键合面积只占芯片面积的很小一部分,接触面积较小成为限制该封装散热性能的关键。该封装中倒装芯片键合层和铜夹连接层对模块热性能的影响比连接散热器的热界面材料的影响更加明显。增大倒装芯片的键合面积有助于降低倒装芯片键合层的热阻,有利于降低芯片结温。研究表明,通过增大芯片电极金属化面积,如将芯片电极面积占比从22%提高到88%,采用倒装键合,芯片结温可降低20-30℃。建议可以通过采用扩大芯片电极金属化面积,增大键合面积的方式来降低热阻。安徽动态测试真空灌胶自动线
上一篇: 天津覆盖膜FPC热压自动置料机行价
下一篇: 辽宁免裁切FPC热压自动置料机