一体化真空炉厂家
基于双基板堆叠和面互连,采用上下双基板堆叠的无键合线平面互连封装。该封装采用Wolfspeed第三代10kVSiCMOSFET芯片构建。芯片焊接在下堆叠基板上,芯片正面电极采用金属Mo柱连接,Mo柱上方连接带有通孔的上堆叠基板。在上堆叠基板的上表面,采用高密度弹簧销端子,将芯片电极连接到PCB母线。Mo柱互连取代键合线连接,提高了机械可靠性,降低了封装杂散电感和电阻。该封装在芯片的两侧均采用平面连接,少部分热量可通过芯片上表面传递给上部堆叠基板,但由于上基板上表面为弹簧端子连接,不利于热量传递,芯片耗散热主要从下堆叠基板散热,使该封装只具有单一散热通路。通过在下堆叠基板底部集成定制的直接射流喷射冷却器,模块结到环境热阻达到0.38℃/W。自动化设备的应用使IGBT模块的封装工艺更加智能化和高效化。一体化真空炉厂家

微通道散热器采用低温共烧陶瓷(LTCC)制成,由于press-pack封装没有内部绝缘,热沉的引入增大了回路的寄生电感,上下两侧的微通道散热器设计可提供足够的散热能力,同时外形上厚度较薄可降低功率回路的电感。微通道散热器的电气回路和冷却回路分离,可以使用非介电流体进行冷却。虽然LTCC的导热性不如金属和AlN陶瓷好,但仿真结果表明,在总热耗散为60W,采用LTCC微通道热沉水冷散热时,SiC芯片至大结温只为85℃,并联芯片间的至大结温差小于0.9℃,并联芯片的结温分布比较均匀。结到热沉热阻为0.2℃/W,热沉至高温度为73℃,热沉到冷却剂的热阻为0.8℃/W。甘肃共晶真空炉市价功率端子键合环节中,IGBT自动化设备能够实现端子的稳固连接。

在2.5D结构中,不同的功率芯片被焊接在同一块衬底上,而芯片间的互连通过增加的一层转接板中的金属连线实现,转接板与功率芯片靠得很近,需要使用耐高温的材料,低温共烧陶瓷(LTCC)转接板常被用于该结构,下图为一种2.5D模块封装结构。而在3D模块封装结构中,两块功率芯片或者功率芯片和驱动电路通过金属通孔或凸块实现垂直互连,是一种利用紧压工艺(Press-Pack)实现的3D模块封装,这种紧压工艺采用直接接触的方式而不是引线键合或者焊接方式实现金属和芯片间的互连,该结构包含3层导电导热的平板,平板间放置功率芯片,平板的尺寸由互连的芯片尺寸以及芯片表面需要互连的版图结构确定,整个结构的厚度一般小于5mm。
BeO的热导率虽与AlN相当,但热膨胀系数过高,且BeO粉体有毒性,吸入人体后会导致慢性铍肺病,世界上大多数国家早已停止使用BeO。相比而言,AlN陶瓷基板具有高的导热性(理论值319W/(m·K))与Si等半导体材料较匹配的热导率、宽的操作温度(工作温度范围和耐高温方面)和优良的绝缘性能,在大功率电力半导体模块、智能功率组件、汽车电子、高密度封装载板和发光二极管(LED)等方面有很好的发展前景,是先进集成电路陶瓷基板重要的材料之一。AlN基板金属化技术主要有厚膜法(TFC)、薄膜法(DPC)、直接覆铜法(DBC)及活性金属钎焊法(AMB)等方法。自动化设备在IGBT模块的封装中提高了生产工艺的稳定性。
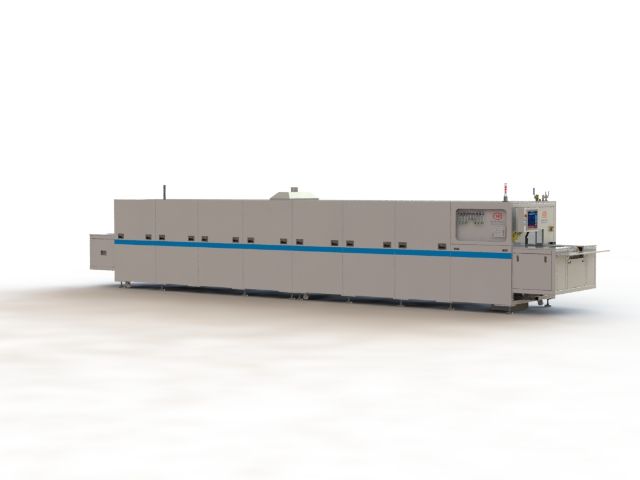
功率器件封装结构散热设计原则:针对功率器件的封装结构,国内外研究机构和企业在结构设计方面进行了大量的理论研究和开发实践,多种结构封装设计理念被国内外研究机构提出并研究,一些结构设计方案已成功应用在商用功率器件上。功率器件自身的属性及其特殊的服役环境决定了封装器件内部总是受到电场、热以及应力等多种场效应相互耦合的综合作用。功率器件的结构设计,应首先要满足电气绝缘要求,在此基础上兼顾结构设计对封装散热、芯片及封装各部件间受力等其他方面的影响。IGBT自动化设备的动态测试能够辅助故障诊断和故障排除。静态测试外壳组装兼容设备厂家
IGBT自动化设备确保封装过程中IGBT模块的稳定性和可靠性。一体化真空炉厂家
采用烧结银工艺将芯片倒装烧结到DBC基板上,芯片背面采用铜夹连接,铜夹上连接散热器,形成芯片上表面的热通路。采用聚合物热界面材料在模块的上下表面连接两个陶瓷散热器,进行双面散热。由于芯片倒装键合面积只占芯片面积的很小一部分,接触面积较小成为限制该封装散热性能的关键。该封装中倒装芯片键合层和铜夹连接层对模块热性能的影响比连接散热器的热界面材料的影响更加明显。增大倒装芯片的键合面积有助于降低倒装芯片键合层的热阻,有利于降低芯片结温。研究表明,通过增大芯片电极金属化面积,如将芯片电极面积占比从22%提高到88%,采用倒装键合,芯片结温可降低20-30℃。建议可以通过采用扩大芯片电极金属化面积,增大键合面积的方式来降低热阻。一体化真空炉厂家
上一篇: 福建精密CCS点胶机参考价
下一篇: 湖北屏蔽膜FPC热压自动置料机供应