山西哪里有英飞凌infineonIGBT模块销售厂家
术语“中心”、“上”、“下”、“左”、“右”、“竖直”、“水平”、“内”、“外”等指示的方位或位置关系为基于附图所示的方位或位置关系,是为了便于描述本发明和简化描述,而不是指示或暗示所指的装置或元件必须具有特定的方位、以特定的方位构造和操作,因此不能理解为对本发明的限制。此外,术语“第1”、“第二”、“第三”用于描述目的,而不能理解为指示或暗示相对重要性。应说明的是:以上所述实施例,为本发明的具体实施方式,用以说明本发明的技术方案,而非对其限制,本发明的保护范围并不局限于此,尽管参照前述实施例对本发明进行了详细的说明,本领域的普通技术人员应当理解:任何熟悉本技术领域的技术人员在本发明揭露的技术范围内,其依然可以对前述实施例所记载的技术方案进行修改或可轻易想到变化,或者对其中部分技术特征进行等同替换;而这些修改、变化或者替换,并不使相应技术方案的本质脱离本发明实施例技术方案的精神和范围,都应涵盖在本发明的保护范围之内。因此,本发明的保护范围应所述以权利要求的保护范围为准。 因为大多数IGBT模块工作在交流电网通过单相或三相整流后的直流母线电压下。山西哪里有英飞凌infineonIGBT模块销售厂家
英飞凌infineonIGBT模块
措施:在三相变压器次级星形中点与地之间并联适当电容,就可以减小这种过电压。与整流器并联的其它负载切断时,因电源回路电感产生感应电势的过电压。变压器空载且电源电压过零时,初级拉闸,因变压器激磁电流的突变,在次级感生出很高的瞬时电压,这种电压尖峰值可达工作电压的6倍以上。交流电网遭雷击或电网侵入干扰过电压,即偶发性浪涌电压,都必须加阻容吸收路进行保护。3.直流侧过电压及保护当负载断开时或快熔断时,储存在变压器中的磁场能量会产生过电压,显然在交流侧阻容吸收保护电路可以抑制这种过电压,但由于变压器过载时储存的能量比空载时要大,还不能完全消除。措施:能常采用压敏吸收进行保护。4.过电流保护一般加快速熔断器进行保护,实际上它不能保护可控硅,而是保护变压器线圈。5.电压、电流上升率的限制4.均流与晶闸管选择均流不好,很容易烧坏元件。为了解决均流问题,过去加均流电抗器,噪声很大,效果也不好,一只一只进行对比,拧螺丝松紧,很盲目,效果差,噪音大,耗能。我们采用的办法是:用计算机程序软件进行动态参数筛选匹配、编号,装配时按其号码顺序装配,很间单。每一只元件上都刻有字,以便下更换时参考。这样能使均流系数可达到。 山西哪里有英飞凌infineonIGBT模块销售厂家IGBT模块标称电流与温度的关系比较大。

空穴收集区8可以处于与第1发射极单元金属2隔离的任何位置,特别的,在终端保护区域的p+场限环也可以成为空穴收集区8,本发明实施例对此不作限制说明。因此,本发明实施例提供的igbt芯片在电流检测过程中,通过检测电阻上产生的电压,得到工作区域的电流大小。但是,在实际检测过程中,检测电阻上的电压同时抬高了电流检测区域的mos沟槽沟道对地电位,即相当降低了电流检测区域的栅极电压,从而使电流检测区域的mos的沟道电阻增加。当电流检测区域的电流越大时,电流检测区域的mos的沟道电阻就越大,从而使检测电压在工作区域的电流越大,导致电流检测区域的电流与工作区域电流的比例关系偏离增大,产生大电流下的信号失真,造成工作区域在大电流或异常过流的检测精度低。而本发明实施例中电流检测区域的第二发射极单元相当于没有公共栅极单元提供驱动,即对于igbt芯片的电子和空穴两种载流子形成的电流,电流检测区域的第二发射极单元只获取空穴形成的电流作为检测电流,从而避免了检测电流受公共栅极单元的电压的影响,以及测试电压的影响而产生信号的失真,即避免了公共栅极单元因对地电位变化造成的偏差,从而提高了检测电流的精度。实施例二:在上述实施例的基础上。
20-电流检测区域;201-第二发射极单元;202-第三发射极单元;30-接地区域;100-公共栅极单元;200-公共集电极单元;40-检测电阻;2-第1发射极单元金属;3-空穴收集区电极金属;4-氧化物;5-多晶硅;6-n+源区;7-p阱区;8-空穴收集区;9-n型耐压漂移层;11-p+区;12-公共集电极金属;13-接触多晶硅;50-半导体功率模块;51-igbt芯片;52-驱动集成块;521-模块引线端子;522-导线;60-dcb板。具体实施方式为使本发明实施例的目的、技术方案和优点更加清楚,下面将结合附图对本发明的技术方案进行清楚、完整地描述,显然,所描述的实施例是本发明一部分实施例,而不是全部的实施例。基于本发明中的实施例,本领域普通技术人员在没有做出创造性劳动前提下所获得的所有其他实施例,都属于本发明保护的范围。如图1所示,igbt器件是由bjt(bipolarjunctiontransistor,双极型三极管)和mos(metaloxidesemiconductor,绝缘栅型场效应管)组成的复合全控型电压驱动式功率半导体器件。在实际应用中,igbt器件兼有mosfet(metal-oxide-semiconductorfield-effecttransistor,金氧半场效晶体管)的高输入阻抗和gtr(gianttransistor,电力晶体管)的低导通压降两方面的优点。 Econo封装(俗称“平板型”):分为EconoDUAL,EconoPIM,EconoPACK之类的。
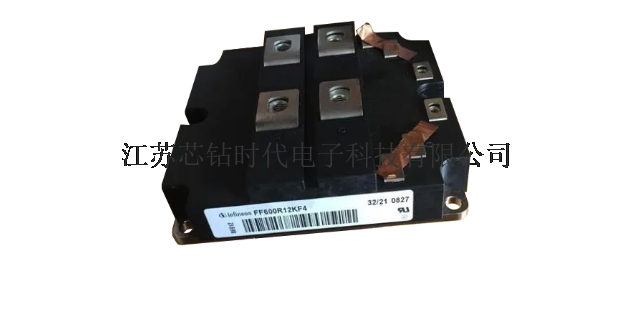
1979年,MOS栅功率开关器件作为IGBT概念的先驱即已被介绍到世间。这种器件表现为一个类晶闸管的结构(P-N-P-N四层组成),其特点是通过强碱湿法刻蚀工艺形成了V形槽栅。80年代初期,用于功率MOSFET制造技术的DMOS(双扩散形成的金属-氧化物-半导体)工艺被采用到IGBT中来。[2]在那个时候,硅芯片的结构是一种较厚的NPT(非穿通)型设计。后来,通过采用PT(穿通)型结构的方法得到了在参数折衷方面的一个明显改进,这是随着硅片上外延的技术进步,以及采用对应给定阻断电压所设计的n+缓冲层而进展的[3]。几年当中,这种在采用PT设计的外延片上制备的DMOS平面栅结构,其设计规则从5微米先进到3微米。90年代中期,沟槽栅结构又返回到一种新概念的IGBT,它是采用从大规模集成(LSI)工艺借鉴来的硅干法刻蚀技术实现的新刻蚀工艺,但仍然是穿通(PT)型芯片结构。[4]在这种沟槽结构中,实现了在通态电压和关断时间之间折衷的更重要的改进。硅芯片的重直结构也得到了急剧的转变,先是采用非穿通(NPT)结构,继而变化成弱穿通(LPT)结构,这就使安全工作区(SOA)得到同表面栅结构演变类似的改善。这次从穿通(PT)型技术先进到非穿通(NPT)型技术,是基本的,也是很重大的概念变化。这就是:穿通。 Infineon那边给出的解释为:IGBT的“损耗”包括“导通损耗”和“开关损耗”。山西哪里有英飞凌infineonIGBT模块销售厂家
Infineon目前共有5代IGBT。山西哪里有英飞凌infineonIGBT模块销售厂家
该电场会阻止P区空穴继续向N区扩散。倘若我们在发射结添加一个正偏电压(p正n负),来减弱内建电场的作用,就能使得空穴能继续向N区扩散。扩散至N区的空穴一部分与N区的多数载流子——电子发生复合,另一部分在集电结反偏(p负n正)的条件下通过漂移抵达集电极,形成集电极电流。值得注意的是,N区本身的电子在被来自P区的空穴复合之后,并不会出现N区电子不够的情况,因为b电极(基极)会提供源源不断的电子以保证上述过程能够持续进行。这部分的理解对后面了解IGBT与BJT的关系有很大帮助。MOSFET:金属-氧化物-半导体场效应晶体管,简称场效晶体管。内部结构(以N-MOSFET为例)如下图所示。MOSFET内部结构及符号在P型半导体衬底上制作两个N+区,一个称为源区,一个称为漏区。漏、源之间是横向距离沟道区。在沟道区的表面上,有一层由热氧化生成的氧化层作为介质,称为绝缘栅。在源区、漏区和绝缘栅上蒸发一层铝作为引出电极,就是源极(S)、漏极(D)和栅极(G)。上节我们提到过一句,MOSFET管是压控器件,它的导通关断受到栅极电压的控制。我们从图上观察,发现N-MOSFET管的源极S和漏极D之间存在两个背靠背的pn结,当栅极-源极电压VGS不加电压时。 山西哪里有英飞凌infineonIGBT模块销售厂家